РОССИЙСКАЯ ФЕДЕРАЦИЯ ФЕДЕРАЛЬНАЯ СЛУЖБА ПО ИНТЕЛЛЕКТУАЛЬНОЙ СОБСТВЕННОСТИ, ПАТЕНТАМ И ТОВАРНЫМ ЗНАКАМ |
(19)
RU
(11)
(13)
C1
|
|||||
|
||||||
| Статус: | не действует (последнее изменение статуса: 02.07.2021) |
| Пошлина: | учтена за 17 год с 29.01.2009 по 28.01.2010. Патент перешел в общественное достояние. |
|
(21)(22) Заявка: 94036010/25, 28.01.1993 (30) Конвенционный приоритет:; (45) Опубликовано: 10.10.1998 (56) Список документов, цитированных в отчете о поиске: DE, заявка, 3138747, A1, кл. H 01 L 29/78, 1983.
(86) Заявка PCT:
|
(71) Заявитель(и):
(72) Автор(ы):
(73) Патентообладатель(и):
|
(54) ПОЛЕВОЙ ТРАНЗИСТОР
(57) Реферат:
Использование: полевые транзисторы с порогом Ферми. Сущность изобретения: усовершенствованный полевой транзистор Ферми с малыми диффузионной емкостью и емкостью затвора, в котором носители заряда могут перемещаться внутри канала на определенной глубине в подложке под затвором, при этом у поверхности полупроводника не требуется создавать инверсионный слой. Для создания полевого транзистора Ферми с малыми емкостями желательно воспользоваться карманом Ферми, имеющим определенную глубину, тип проводимости которого противоположен типу проводимости подложки и совпадает с типом проводимости областей диффузии для формирования стока и истока. Техническим результатом изобретения является создание усовершенствованного полевого транзистора с порогом Ферми с пониженными диффузионной емкостью и емкостью затвора. 11 з.п. ф-лы, 24 ил.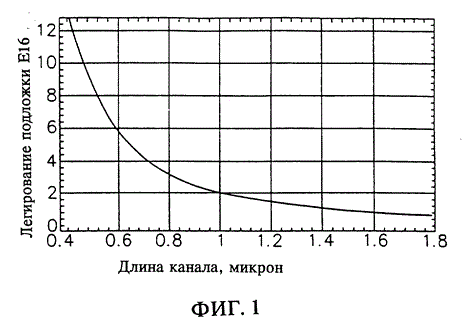
Область техники, к которой относится изобретение
Данное изобретение относится к полевым транзисторам, а более конкретно оно касается полевых транзисторов с порогом Ферми с пониженными затвором и диффузионной емкостью.
Уровень техники
В настоящее время полевые транзисторы (ПТ) стали основными активными приборами, применяемыми в микросхемах сверхвысокой (VLSI) и ультравысокой степени интеграции (ULSI), так как они в силу своей природы имеют высокий импеданс и обеспечивают высокую плотность упаковки и малую потребляемую мощность. Тем не менее усилия исследователей и разработчиков направлены на дальнейшее повышение их быстродействия и увеличение плотности упаковки, а также на уменьшение потребляемой ими мощности.
Известен высокоскоростной ПТ со структурой металл-оксид-полупроводник (МОП), пороговое напряжение которого не зависит от толщины изоляционного слоя, длины канала, напряжения стока, легирования подложки и температуры, что позволило получить высокоскоростной полевой транзистор (см. патенты США NN 4984043 и 4990974, выданные на имя Albert W. Vinal под названием "Полевой транзистор с порогом Ферми"). Хотя созданный полевой транзистор с порогом Ферми значительно лучше типовых МОП-транзисторов, все же в структуре полевого транзистора с порогом Ферми желательно уменьшить емкость.
Известен также работающий в режиме обеднения полевой транзистор, у которого между областью истока и областью стока имеется область обеднения того же типа проводимости, а также между областью истока и областью стока имеются дополнительные полупроводниковые области того же типа проводимости, которые образуют с подложкой обычный p-n-переход (см. выложенную заявку ФРГ DE-A-3138747).
Сущность изобретения
Достигаемым при осуществлении настоящего изобретения техническим результатом является создание усовершенствованного полевого транзистора с порогом Ферми с пониженными затвором и диффузионной емкостью.
Данная задача решается за счет того, что полевой транзистор, содержащий полупроводниковую подложку первого типа проводимости с первой поверхностью, область кармана второго типа проводимости в подложке у первой поверхности, разнесенные области истока и стока второго типа проводимости в области кармана у первой поверхности, изоляционный слой затвора на подложке на первой поверхности между разнесенными областями истока и стока и контакты истока, стока и затвора для электрического контактирования с областями истока и стока и изоляционным слоем затвора соответственно, согласно настоящему изобретению дополнительно содержит канал второго типа проводимости в области кармана у первой поверхности между разнесенными областями истока и стока. Указанный канал проводимости проходит на первой определенной глубине от первой поверхности, а область кармана проходит на второй определенной глубине от канала. Область истока проходит на третьей определенной глубине от первой поверхности, причем третья глубина больше первой глубины и меньше суммы первой и второй глубин.
Возможно легирование истока примесью второго типа проводимости при концентрации легирующей примеси, уменьшающейся от первой поверхности до третьей определенной глубины. В данном случае предпочтительно, чтобы центр масс легирующей примеси находится на глубине, равной половине первой определенной глубины.
Целесообразно выбирать по меньшей мере одну из определенных первой и второй глубин так, что составляющая электрического поля, перпендикулярная первой поверхности, на первой определенной глубине была равна нулю.
Предпочтительно также, чтобы по меньшей мере одна из определенных первой и второй глубин дополнительно выбиралась так, что составляющая электрического поля, перпендикулярная первой поверхности, от первой определенной глубины до первой поверхности при приложении порогового напряжения к контакту затвора была равна нулю.
Вторая определенная глубина может выбираться для создания такого порогового напряжения у полевого транзистора, которое равно удвоенному потенциалу Ферми полупроводниковой подложки.
Возможен также выбор по меньшей мере одной из определенных первой и второй глубин такой, чтобы носители заряда второго типа проводимости могли течь из области истока к области стока по области канала, проходящей от первой определенной глубины к первой поверхности по приложении к контакту затвора напряжения, превышающего пороговое напряжение полевого транзистора.
По меньшей мере одна из определенных первой и второй глубин может выбираться такой, чтобы носители заряда второго типа проводимости могли перемещаться внутри области канала от области истока к области стока и под первой поверхностью без создания инверсионного слоя в канале.
Целесообразно также снабжать подложку электрическим контактом. В этом случае контакт затвора содержит слой поликристаллического кремния первого типа проводимости и затворный электрод на слое поликристаллического кремния против изоляционного слоя затвора, причем по меньшей мере одна из определенных первой и второй глубин выбирается для создания такого напряжения на первой поверхности, смежной с изоляционным слоем затвора, которое равно и противоположно по знаку сумме напряжений между контактом подложки и подложкой и между слоем поликристаллического кремния и электродом затвора.
Предпочтительно, чтобы подложка была снабжена электрическим контактом, при этом по меньшей мере одна из первой и второй определенных глубин выбирается для изменения порогового напряжения полевого транзистора менее чем на одну двадцатую вольта, когда напряжение, приложенное к контакту подложки, меняется на один вольт.
Предпочтительно также легирование подложки с концентрацией легирующей примеси Ns. В этом случае подложка имеет собственную концентрацию носителей заряда Ni при температуре T градусов Кельвина и диэлектрическую проницаемость es. Полевой транзистор содержит электрический контакт подложки, и канал в нем проходит на первой определенной глубине Yf от первой поверхности, а область кармана проходит на второй определенной глубине Yo от канала. При этом область канала легируется с такой концентрацией легирующей примеси, которая в α раз отличается от Ns. Затворный контакт содержит слой поликристаллического кремния первого типа проводимости, легированный с концентрацией легирующей примеси Np. При данном выполнении первая определенная глубина Yf определяется из следующего соотношения:

где q равняется 1,6•10-19 Кулон, а K равен 1,38•10-23 Дж/К.
При легировании подложки согласно вышеуказанному варианту выполнения изобретения целесообразно также, чтобы вторая определенная глубина Y0 была равна

где
фs равняется 2фf+ KT/q Lnα , а фf - потенциал Ферми полупроводниковой подложки.
В соответствии с вышеизложенной сущностью настоящего изобретения технический результат достигается за счет создания структуры полевого транзистора с порогом Ферми, в котором носители заряда могут течь по каналу под затвором на заранее заданной глубине в подложке, при этом на поверхности полупроводника не надо создавать инверсионный слой, поддерживающий протекание носителей. Соответственно при расчете емкости затвора у средней глубины заряда в канале требуется учесть диэлектрическую постоянную подложки. Тем самым емкость затвора уменьшается.
Для создания полевого транзистора желательно использовать зону кармана Ферми заранее заданной глубины, тип проводимости которой противоположен типу проводимости подложки и совпадает с типом проводимости у областей диффузии для формирования стока и истока. Карман Ферми находится на заранее определенной глубине от поверхности подложки, при этом области диффузии для стока и истока формируются в кармане Ферми внутри его границ.
Соответственно зона канала Ферми с заранее глубиной Yf и шириной Z проходит между областями диффузии для формирования стока и истока. Проводимость канала Ферми регулируется напряжением, прикладываемым к электроду затора. Поэтому емкость затвора в первую очередь определяется глубиной канала Ферми и распределением носителей заряда в канале, и эта емкость относительно не зависит от толщины оксидного слоя затвора. Диффузионная емкость обратно пропорциональна разности между суммой глубин кармана Ферми и обеднения Yo в подложке и глубиной диффузий. В результате получается полевой транзистор Ферми с малой емкостью. Предпочтительная глубина кармана Ферми равна сумме глубин канала Ферми Yf и обеднения Yo.
Краткое описание чертежей
Изобретение поясняется чертежами, на которых изображено следующее: на фиг. 1 графически изображено легирование подложки в функции длины канала для поддержания пробивного напряжения, равного 8 вольт;
на фиг. 2 графически изображена емкость зоны обеднения при нулевом напряжении на стоке в функции длины канала, соответствующей концентрации легирования, изображенной на фиг. 1;
на фиг. 3 - вид в поперечном сечении типового полевого транзистора структуры МОП с углубленным N-каналом;
на фиг. 4 - вид в поперечном сечении полевого транзистора Ферми;
на фиг. 5 - вид в поперечном сечении быстродействующего полевого транзистора Ферми согласно данному изобретению;
на фиг. 6-10 - виды в поперечном сечении электрической проводимости канала в быстродействующем полевом транзисторе Ферми по фиг. 5 при увеличении напряжения затвора;
на фиг. 11 графически изображен профиль инжекции избыточных носителей заряда в функции глубины канала Ферми;
на фиг. 12а и 12б - графики тока стока для типового полевого транзистора структуры МОП с P-каналом быстродействующего полевого транзистора Ферми при идентичных размерах;
на фиг. 13а и 13б графически показана емкость затвора у быстродействующего полевого транзистора Ферми с каналом P-типа и полевого транзистора структуры МОП с каналом P-типа соответственно;
на фиг. 14 - график отношения емкости затвора у полевых транзисторов МОП и Ферми в функции толщины оксида;
на фиг. 15 - распределение электрического поля в быстродействующем полевом транзисторе Ферми с каналом N-типа;
на фиг. 16 графически изображена глубина канала Ферми в функции концентрации легирующих примесей;
на фиг. 17 графически показана зависимость глубины кармана Ферми от концентрации легирующих примесей;
на фиг. 18 графически показана зависимость порогового напряжения от концентрации легирующих примесей;
на фиг. 19 графически показана зависимость дельты напряжений плоских зон от концентрации легирующих примесей;
на фиг. 20 - вид в поперечном сечении зоны обеднения, окружающей диффузии, предусматриваемые карманом Ферми;
на фиг. 21а-21г - графики, иллюстрирующие замеры влияния подложки и истока у типовых МОП-транзисторов и полевого транзистора Ферми;
на фиг. 22 изображено распределение электрического поля в типовом МОП-транзисторе;
на фиг. 23 и 24 - графики, изображающие зависимость порогового напряжения от напряжения подложки.
Сведения, подтверждающие возможность осуществления изобретения
Далее изобретение описывается более подробно со ссылками на поясняющие чертежи с изображением предпочтительного варианта выполнения изобретения. Вместе с тем данное изобретение может реализоваться в самых различных формах и потому представленный вариант изобретения не ограничивает его, он предназначен лишь для более полного и законченного описания изобретения, делая его более понятным для специалистов. Во всем описании одинаковые позиционные обозначения относятся к аналогичным элементам.
Далее рассмотрена усовершенствованная структура полевого транзистора Ферми, у которого величины диффузионной емкости и емкости затвора значительно меньше соответствующих величин, достигаемых в типовых МОП-транзисторах и полевых транзисторах Ферми, являющихся прототипами изобретения.
Предложенная новая структура полевого транзистора Ферми обеспечивает протекание носителей заряда в канале на заранее определенной глубине в подложке под затвором. Создание новой структуры является результатом теоретических и экспериментальных исследований типовых МОП-структур и известных полевых транзисторов Ферми (см. патенты США NN 4990974 и 4984043). В ходе исследований было сделано открытие о необходимости соблюдений некоторых электрических и физических условий для движения носителей заряда в зоне канала на существующей глубине в подложке под оксидным слоем затвора. В отличие от новых полевых транзисторов, в типовых МОП-приборах для движения носителей зарядов требуется создание инверсионного слоя у поверхности полупроводника. Обычно глубина инверсионного слоя составляет 200 ангстрем или меньше. При подобных условиях емкость затвора определяется диэлектрической проницаемостью изоляционного слоя затвора, деленной на его глубину. Иными словами, заряд в канале настолько близок к поверхности, что влиянием диэлектрических свойств подложки на емкость затвора можно пренебречь. Емкость затвора можно уменьшить лишь тогда, когда протекание носителей заряда ограничивается зоной канала под затвором, где средняя глубина заряда в канале для расчета емкости затвора требует учета диэлектрической постоянной подложки. В общем случае емкость затвора быстродействующего полевого транзистора Ферми описывается следующим уравнением:

Коэффициент Yf представляет глубину канала проводимости, называемого каналом Ферми, es является диэлектрической проницаемостью подложки, β является коэффициентом, определяющим среднюю глубину заряда, текущего под поверхностью в канале Ферми. Коэффициент β зависит от профиля распределения по глубине носителей заряда, инжектированных в канал из истока. В случае быстродействующего полевого транзистора Ферми β ≈ 2. Параметр Tox представляет толщину оксидного затворного слоя, а ei представляет его диэлектрическую проницаемость.
В соответствии с уравнением (1) емкость затвора можно уменьшить в 2 раза одним лишь регулированием глубины Yf канала Ферми и профиля инжекции истока, определяемого β. В частности, емкость затвора быстродействующего транзистора Ферми составляет 1/2 величины МОП-транзистора ei/Tox, когда
 (2)
(2)
Для выполнения этого условия глубина канала Ферми Yf должна превышать определенную величину

Обычно Yf > 6Tox для β = 2.
Условия, способствующие протеканию носителей заряда на значительных глубинах под поверхностью полупроводника, неочевидны. Для открытия этих условий потребовались значительные теоретические проработки, подкрепленные экспериментом. А именно, необходимо соблюдение двух основных условий.
1. Когда происходит протекание избыточных носителей заряда, в области канала не должно быть перпендикулярных составляющих электрического поля помимо той, что образуется самими избыточными носителями заряда.
2. Инжекционный барьерный потенциал KT/q Ln(NdNc/N
| 2 |
| i |
3. Концентрация легирующих примесей внутри области диффузии формирования истока в функции глубины должна уменьшаться с заранее определенной скоростью для поддержания правильного глубинного профиля для индуцированной инжекции носителей заряда в канал.
Динамическую емкость затвора можно измерить лишь на реальных транзисторных структурах, когда напряжение стока превышает ноль. Зона затвора ограничивается зоной между истоком и стоком. Обычная методика замера емкости затвора МОП-транзисторов не позволяет выявить действительную динамическую емкость затвора у быстродействующих полевых транзисторов Ферми по причине паразитных побочных зарядов и отсутствия инжекционного профиля. Измеряемая на реальных транзисторах емкость затвора является средством производственного контроля и используется как технологический замер.
Скорость работы цифровых микросхем напрямую зависит от диффузионной барьерной емкости. Малая диффузионная барьерная емкость несовместима с МОП-транзисторами с коротким каналом. Эта емкость в основном определяется как отношение диэлектрической проницаемости подложки к суммарной глубине зоны обеднения, окружающей области диффузии при формировании стока и истока. Диффузионная барьерная емкость состоит из двух основных компонентов, связанных с площадью и периметром. Компонент, связанный с площадью, отмечается у дна области диффузии. Компонент, связанный с периметром, известен под названием боковой емкости. В МОП-транзисторах преобладающим компонентом является боковая емкость из-за увеличения легирующих примесей в подложке близ областей диффузии для получения областей ограничения канала. В быстродействующем полевом транзисторе Ферми необходимость в областях ограничения отсутствует.
Боковая емкость определяется следующим выражением:
Cdp = C
| * |
| sw |
Компонент емкости, связанный с площадью, определяется следующим выражением:
Cda = C
| * |
| a |
где
Z - ширина канала;
Xd - глубина диффузии;
Ld - длина диффузии.
У быстродействующих полевых транзисторов Ферми


где
es представляет собой диэлектрическую проницаемость полупроводникового материала, Yn + Yp представляет суммарную глубину обеднения, окружающую область диффузии стока или истока, Ytub представляет глубину кармана Ферми, Yo + Yp представляет глубину обеднения боковой стенки, Xd - глубину диффузии.
В МОП-транзисторах глубина обеднения обратно пропорциональна концентрации легирующих примесей в подложке Ns. К примеру, в МОП-транзисторах существует фундаментальное условие пробоя, называемого также проколом. Ниже приведено условие предупреждения прокола в виде концентрации легирующих примесей в подложке в функции длины канала и пробивного напряжения:



Диффузионная емкость описывается следующим выражением:

На фиг. 1 показан график легирования в функции длины канала для поддержания напряжения пробоя, равного 8 В.
На фиг. 2 показано, как меняется емкость области обеднения (Ф/см2) при нулевом напряжении на стоке в функции длины канала, которая соответствует изображенной на фиг. 1 концентрации легирования.
Требования по легированию подложки быстро растут с укорочением длины канала из-за необходимости совладать с механизмом пробоя. У МОП-приборов с длиной канала 0,8 мкм и меньше типичной является диффузионная емкость 0,5 • 10-7 Ф/см2. В новом быстродействующем полевом транзисторе Ферми указанная величина диффузионной емкости меньше приблизительно в 3 раза. Устранение пробоя достигается особым методом кармана Ферми, используемым при изготовлении быстродействующего полевого транзистора. В полевых приборах Ферми типичной для подложки является концентрация легирующих примесей 1E16.
В конструкции нового быстродействующего транзистора Ферми одновременно решены несколько фундаментальных проблем, присущих полевым транзисторам с коротким каналом, при этом найденное решение обеспечивает получение малой емкости затвора.
1. Исключен прокол.
2. Практически исключена зависимость порогового напряжения от толщины оксида.
3. Происходит существенное уменьшение компонентов емкости, связанных с площадью и периметром.
4. Конструкция кармана Ферми значительно упрощает изготовление приборов с каналом P-типа.
5. Наблюдается уменьшение тока насыщения при заданном напряжении затвора, несмотря на уменьшение заряда канала на единицу напряжения на затворе.
6. В приборах с каналами P- и N-типа действуют одинаковые конструктивные критерии.
7. Приборы эксплуатируются с источником питания 5 вольт.
8. Устранено явление уменьшения индуцированного барьера стока, обычно наблюдаемое на приборах с заглубленным каналом.
9. Устранен сдвиг порогового напряжения, вызываемый разностью напряжений плоских зон между контактами затвора и подложки.
10. Существенно устранена проблема горячих электронов.
11. Исключена необходимость в областях ограничения канала.
12. Возможно управление пороговым напряжением,
13. Обеспечивается чрезвычайно малый эффект подложки.
Обсуждение проблемы
Скорость работы цифровых интегральных схем зависит от шести основных параметров транзисторов, а также от влияния паразитных емкостей, связанных с соединительными цепями. В конечном счете скорость интегральных микросхем ограничивается временем задержки в логических цепях. Можно показать, что время задержки в цепи из нескольких логических элементов определяется следующим уравнением:

Временем логической задержки и, в конечном счете, скоростью работы системы управляют шесть основных транзисторных параметров.
1. Ток насыщения канала I
| * |
| satn |
2. Длина канала Lo. Это эффективная длина проводящего канала.
3. Диффузионная емкость C
| * |
| d |
4. Емкость затвора C
| * |
| g |
5. Длина диффузии Ld.
6. Отношение η тока насыщения канала N-типа к току насыщения канала P-типа.
Из уравнения (7) видно, что коэффициент задержки во времени зависит от квадрата длины канала Lo. Из коэффициента также прослеживается обратная пропорциональность тока насыщения канала в приборе с каналом N-типа в схемах на КМОП-транзисторах. В этот коэффициент входит и фактор η. Он определяет отношение токов насыщения канала N-типа и P-типа. Указанный в уравнении (7) параметр φ введен из патента США N 5030853 (Кольцевой сегментный буфер), описание которого используется как ссылочный материал. Внутри выражения в скобках имеются три емкостных члена - это диффузионная емкость C
| * |
| d |
| * |
| g |
| * |
| c |
Для уменьшения времени задержки в логической цепи можно применить различные средства. Обычно стараются уменьшить длину канала либо увеличить ток насыщения стока. Однако уменьшение размеров транзисторов с целью получить приборы с более коротким каналом приводит к нежелательному увеличению емкости затвора, а также барьерной емкости. Пример этого представлен на фиг. 2. Барьерная емкость увеличивается в результате увеличения плотности легирующих примесей в подложке с целью предотвратить прокол в приборах с коротким каналом. Емкость затвора увеличивается в результате пропорционального уменьшения толщины оксидного слоя затвора Tox.
К примеру, в технологии изготовления интегральных микросхем из арсенида галлия для уменьшения задержки стараются увеличить нагрузочную способность по току. К сожалению, подвижность зарядов в канале из GaAs близ истока приближаются к значениям, присущим кремнию, поскольку длина канала становится менее 0,8 микрона. Значительное повышение потребляемой мощности постоянного тока для достижения скорости в приборах с каналом N-типа по сравнению с КМОП-транзисторами представляется непрактичным в свете применения кремниевых приборов на диодах Шоттки.
Вторым и более практичным подходом к повышению скорости работы интегральных микросхем является минимизация емкостных членов C
| * |
| d |
| * |
| g |
| * |
| c |
| * |
| satn |
Уменьшить соединительную емкость C
| * |
| c |
Ключом к скоростным цифровым системам является предельное увеличение скорости нарастания выходного напряжения, отношения тока в канале к нагрузочной емкости наряду с минимизацией мощности. Минимизация емкостной нагрузки (в первую очередь затвора и барьера) при сохранении или даже увеличении тока возбуждения является единственным путем к достижению высоких рабочих скоростей при минимальном потреблении мощности. Принцип уменьшения емкости затвора при сохранении тока возбуждения тесно связан с влиянием, которое концентрация носителей заряда в канале оказывает на подвижность носителей. Поскольку в токе стока полевого транзистора учитывается произведение напряжения на затворе и емкости или заряда затвора, то технология быстродействия полевых транзисторов Ферми позволяет получить такую же или более высокую допустимую нагрузку потоку наряду со значительно меньшим полным зарядом, текущим по каналу, на единицу тока.
Конструкция быстродействующих полевых транзисторов Ферми
Особенностью предлагаемой конструкции является фундаментальное дополнение к структуре полевых транзисторов Ферми, раскрытых в вышеуказанных патентах. В соответствии с данным изобретением это дополнение уменьшает емкость затвора и барьерную емкость. Более наглядное представление об этом изменении можно получить сравнением новой структуры по фиг. 5 с ранее известными структурами по фиг. 3 и 4.
На фиг. 3 изображено базовое техническое решение в виде МОП-транзистора с каналом P-типа. Такой структуре присущи два основных недостатка. Во-первых, из-за механизма прокола в ней происходит пробой напряжением. Во-вторых, наблюдается явление уменьшения индуцированного барьера стока, которое стремится перевести канал в проводящее состояние в случае приложения напряжения к стоку. Обе проблемы возникают в результате разделения индуцированного заряда в области обеднения подложки под заглубленным каналом. Чтобы минимизировать эти эффекты, приходится применять сильное легирование области подложки. Однако в результате происходит резкое увеличение диффузионной емкости. Мотивацией к созданию прибора с незначительно заглубленным каналом было, судя по всему, стремление улучшить ток насыщения при заданном напряжении на затворе.
На фиг. 4 изображена структура полевого транзистора Ферми, принятого за прототип. В этой конструкции устранены понижение индуцированного барьера стока и прокол, когда глубина канала Yo равна глубине областей диффузии для формирования стока и истока. При такой конфигурации легирование подложки не должно быть очень высоким и потому можно уменьшить диффузионную емкость стока. Однако емкость затвора у такой структуры лишь немного меньше емкости в МОП-транзисторе, несмотря на глубину канала Ферми.
Когда первый полевой транзистор Ферми был запатентован, то были еще неизвестны условия, требуемые для управления распределением заряда в области канала в случае его проводимости. На фиг. 5 показана базовая структура быстродействующего полевого транзистора Ферми по данному изобретению.
Базовое физическое различие состоит в наличии области кармана Ферми, отмеченной на этой фигуре. Тип проводимости кармана Ферми совпадает с типом проводимости областей диффузии стока и истока, при этом глубина кармана равна сумме двух факторов, а именно глубине канала Ферми Yf и глубине барьера Yo. Указанные глубины подчиняются специфичным конструктивным критериям, более подробно рассмотренным ниже. Благодаря этому в новой конструкции канал Ферми Yf может обеспечить протекание носителей заряда с особым профилем концентрации по всей своей глубине. Требуемый профиль концентрации можно достичь лишь с помощью структуры, изображенной на фиг. 5. Эта структура также удовлетворяет всем критическим конструктивным критериям, соблюдение которых требуется для получения малой емкости затвора. Как видно из фиг. 5, глубина областей диффузии Xd должна быть больше или равна глубине канала Ферми Yf, но не должна превышать суммы Yf + Yo. Глубина обеднения подложки на фиг. 5 обозначена как Yp. Когда напряжение на затворе меньше порогового напряжения, в канале Ферми Yf нет носителей заряда. В этих обстоятельствах емкость затвора весьма мала и имеет следующую величину:

Диффузионная емкость на единицу площади также мала и равняется

Зависимость проводимости канала от напряжения на затворе
На фиг. 6 - 10 представлен процесс моделирования проводимости канала с увеличением напряжения на затворе. На всех чертежах изображен канал N-типа. Приборы с каналом P-типа выполняются аналогично путем замены материала проводимости N-типа на материал с проводимостью P-типа и наоборот. На фиг.6 показан канала Ферми, где совершенно нет носителей заряда. На фиг.7 - 9 показаны ионизированные доноры, нейтрализуемые со дна канала, в результате чего проводимость канала Ферми начинается со дна. При большем напряжении на затворе избыточные носители заряда инжектируются у истока и имеют распределение, изображенное на фиг. 10.
Профиль инжекции в канале Ферми
В любом полевом транзисторе носители заряда, текущие в области канала, инжектируются туда из истока в случае приложения напряжения к истоку. Распределение избыточных носителей заряда по профилю глубины канала подчиняется механизму инжекции. Инжекция основных носителей заряда является следствием существования электрического поля между электродом затвора и поверхностью области диффузии истока, обращенной к каналу. Носители заряда, инжектируемые из стока в торец канала, не должны испытывать ограничения со стороны поверхности. Инжекция должна равномерно распределяться в направлении глубины канала Ферми. Весьма важно, чтобы профиль легирования в области диффузии истока был неравномерным, а предпочтительней таким, чтобы концентрация примесей составляла приблизительно 2E19 у поверхности, спадая с глубиной по меньшей мере на одну декаду между верхом канала Ферми и его дном. Именно такой градиент требуется, чтобы достичь полезного распределения инжекции избыточных носителей заряда по всей глубине канала Ферми, обеспечивая тем самым значительное уменьшение емкости затвора. В идеале желательно, чтобы центр массы избыточных носителей заряда лежал на половине глубины канала Ферми. Когда центр заряда лежит на половине глубины канала Ферми, емкость затвора у быстродействующего полевого транзистора Ферми становится равной

Типовой профиль инжекции избыточных носителей заряда в функции глубины канала Ферми изображен на фиг. 11.
Концентрация легирующей примеси наверху области диффузии равна 2E19, а у дна канала она равна 5E17. Обратим внимание на точку перегиба в кривой профиля. Среднее положение заряда при таком профиле находится приблизительно на половине глубины канала Ферми.
Ток стока
Была проделана значительная теоретическая и экспериментальная работа с целью доказать, что в быстродействующих полевых приборах Ферми не происходит ухудшения тока стока в сравнении с МОП-транзистором, несмотря на значительное уменьшение заряда в канале на единицу тока. Причина состоит в том, что подвижность носителей заряда растет пропорционально суммарному уменьшению заряда. Иными словами, концентрация носителей уменьшается соответственно увеличению их подвижности. Энергия в канале у полевого транзистора Ферми 1/2CgV
| 2 |
| g |
| 2 |
| g |
На фиг. 12а и 12б представлены графики тока стока для МОП-транзистора с P-каналом и полевого транзистора Ферми, имеющих идентичные размеры, L = Z = 0,8 мкм, и идентичную толщину оксидного слоя 165A. Легирование подложки для МОП-транзистора равно 1E17 на см3 и 1E16 для быстродействующего полевого транзистора Ферми. Обратим внимание, что транзистор Ферми при заданном напряжении на затворе и стоке пропускает больше тока, чем МОП-транзистор, несмотря на то, что емкость затвора и барьерная емкость составляют соответственно 47% и 30% от значений емкостей у МОП-транзистора. В результате скорость переключения логических схем, выполненных на быстродействующих полевых транзисторах Ферми, приблизительно в 2,5 раза выше, чем у таких же схем, выполненных на МОП-транзисторах при такой же рабочей мощности.
Замер емкости затвора
В литературе приводится масса информации по замеру емкостей в МОП-транзисторах. Однако какой-либо информации по замеру емкости затвора с использованием реальных транзисторных структур нет. Причина этого вероятно заключается в том, что у МОП-транзисторов заряд в канале очень близок к поверхности и находится в области приблизительно 200 ангстрем и менее. Однако эта причина не действует для быстродействующих транзисторов Ферми, поскольку у них профиль инжекции регулируется для получения больших глубин инжекции. Методы замера емкостей в МОП-транзисторах не позволяют выявить емкость затвора у быстродействующих транзисторов Ферми. У МОП-транзисторов инжекция в ионизированную область под инверсионный слой незначительна вследствие высоты барьера между источником диффузии и ионизированной областью, обращенной к участку диффузии. Инжекция происходит ближе к поверхности, где барьер, вследствие процесса инверсии, опускается.
Замеры емкости затвора для быстродействующих транзисторов Ферми проводятся на реальных транзисторных структурах. Для устранения емкости, создаваемой контактными площадками, приходится проводить дифференциальное измерение. Подобный метод достаточно прост, он применяется для контроля технологического процесса. Площадь затвора четко определяется как произведение ширины Zс и длины Lс канала. Транзисторные структуры нужны для замера по той причине, что распределение заряда и, следовательно, емкость затвора, в первую очередь, определяется профилем инжекции у истока. Профиль инжекции носителей заряда, как функция глубины у истокового конца канала, остается практически неизменным на интервале между истоком и стоком на протяжении времени пролета. Причина заключается в том, что в канале Ферми отсутствует вертикальная составляющая электрического поля помимо той, что создается самими носителями заряда. Вертикальная составляющая электрического поля на переходе подложка-карман Ферми равна нулю у дна канала Ферми, оставаясь равной нулю по всей глубине канала, где канал Ферми имеет нейтральный заряд.
На фиг.13а представлен график для быстродействующего транзистора Ферми с каналом P-типа, на фиг.13б представлен аналогичный график для МОП-транзистора также с каналом P-типа.
Из фиг.13а видно, что, пока напряжение на затворе ниже порога, инверсия заряда происходит в области канала Ферми. В этой области графика емкость затвора описывается следующем уравнением:

где
δ - глубина инверсии.
Когда напряжение затвора находится близ порога, емкость затвора весьма мала:

Когда напряжение затвора превышает порог, емкость затвора приближается к значению, описываемому следующим уравнением:

Величина β зависит от градиента концентрации внутри области диффузии истока в направлении глубины. Обычно β равна 2.
На фиг. 13б представлен график динамической емкости затвора, замеренной на МОП-транзисторе. Здесь, судя по всему, нет различий между областями инверсии и накапливания. Минимальное значение емкости в МОП-структуре определяет глубина области ионизации под затвором в подложке. Однако при возникновении инверсии емкость резко возрастает до типового значения еi/Tох.
При всех замерах емкости с использованием реальных транзисторов к стоку прикладывается напряжение для устранения паразитного заряда и для движения инжектированного заряда.
На фиг. 14 представлен график отношения емкостей затвора у МОП-транзистора и транзистора Ферми в функции толщины оксидного слоя при условии, что глубина канала Ферми составляет 1200 ангстрем.
Анализ быстродействующих полевых транзисторов Ферми
Далее описаны условия имплантации кармана и канала Ферми, которые обеспечивают корректирование разности напряжений плоских зон между поликристаллическим кремниевым затвором и контактом подложки. Емкость затвора и диффузионная емкость уменьшаются за счет регулирования глубины и дозы в области кармана Ферми. На фиг. 15 изображено распределение электрического поля в быстродействующем полевом транзисторе Ферми с каналом N-типа, откуда видно взаимное обеднение кармана, канала и подложки под затвором при пороговых условиях.
Выходящая за ось абсцисс составляющая электрического поля на фиг.15 объясняется глубиной канала Ферми Yf, создаваемой на глубине имплантации кармана Ферми для минимизации дифференциальных эффектов между контактом затвора и контактом подложки. Указанная глубина канала определяет область, где происходит движение носителей заряда. Область канала Ферми имеет достаточную глубину и поэтому центр масс заряда лежит на значительной глубине под поверхностью при условии правильного профиля инжекции область диффузии-канал. Перечисленные факторы влияют на существенное уменьшение емкости затвора. Пороговое напряжение известного полевого транзистора Ферми равняется двойному потенциалу Ферми, если разность между контактными потенциалами затвора и подложки равна нулю. Однако на практике концентрация легирующей примеси в поликристаллическом затворе должна быть большой для устранения трудностей с выпрямительными контактами. Вследствие этих контактных потенциалов разностное напряжение описывается уравнением

где
Np - концентрация легирующей примеси в поликристаллическом затворе,
Ns - концентрация легирующей примеси в подложке.
Обычно дельта напряжений в плоских зонах составляет 200 милливольт. Из фиг.15 видно, что потенциал в треугольной области над осью абсцисс равен

Если установить потенциал ф равным разности напряжений плоских зон Δfb, то получится соотношение для определения глубины канала Ферми

где
α = Nc/Ns, Nc - концентрация компенсирующего легирования в кармане Ферми, Ns - концентрация легирующей примеси в подложке в см3.
Суммарная глубина кармана Ферми под затвором равняется Ytub = Yf+Yо, где Yо - глубина области обеднения в кармане Ферми вследствие контакта с подложкой,

Следовательно, глубина Ферми равна сумме Yf и Yо.

В предыдущих патентах по транзисторам Ферми отмечался тот факт, что глубина области обеднения в подложке Yp описывается следующим уравнением:

Задавшись указанными условиями, рассчитывают электрическое поле E(O) и потенциал фs на поверхности канала под оксидным слоем затвора при пороговом напряжении. Согласно фиг.15 поле описывается следующим уравнением:

Поскольку E - градиент потенциала, рассчитывают потенциал как функцию расстояния y и, частности, на поверхности, где y = 0.

Определив (21) на поверхности, получают

Воспользовавшись определениями для Yp, Yf и Yo, определяют следующее выражение:

Приводя члены и упрощая, получают уравнение
Ф(O) = Ф - Δf , (24)

Таким образом, получив глубину имплантации кармана Ферми, равную сумме Yo + Yf, поверхностный потенциал, появляющийся между контактами поликристаллического затвора и подложки, уменьшается точно на разность напряжений плоских зон. В результате этого пороговое напряжение становится равным двойному потенциалу Ферми. Иными словами, учет глубины Yf, как части требования по глубине кармана Ферми, устраняет смещение разности напряжения на плоских зонах из-за разности потенциалов на контактах затвора и подложки. Другой возможной модификацией порогового напряжения в быстродействующем транзисторе Ферми является уменьшение порогового напряжения ниже двойной величины Ферми на величину потенциала оксидного слоя у порога в силу компенсации плоской зоны. Необходимо отметить, что направленное электрическое поле в оксидном слое должно отводить носители заряда от грани раздела оксид-кремний. Этот эффект способствует уменьшению емкости. Оказалось, что потенциал оксидного слоя описывается следующим выражением:

Примечание: член напряжения оксидного слоя имеет полярность, противоположную полярности на подложке МОП-транзистора, и имеет сравнительно небольшую величину.
Ниже приведено выражение для порогового напряжения быстродействующего транзистора Ферми:

где
Np - легирующая примесь в поликристаллическом кремнии,
Npo - легирующая примесь в поликристаллическом кремнии, используемая при изготовлении полупроводниковых пластин,
Ns - концентрация легирующей примеси в подложке.
Итоговые расчетные уравнения
Для расчета быстродействующего полевого транзистора Ферми используются следующие уравнения:
уравнение глубины имплантации кармана Ферми Ytub (18),
уравнение глубины канала Ферми Yf (16),
уравнение дельты напряжения плоских зон (14),
уравнение порогового напряжения (26),
уравнение напряжения оксидного слоя (25).
Если быстродействующие полевые транзисторы Ферми работают в режиме обогащения, то глубина канала Ферми имеет следующее максимальное значение:

Диффузия для боковой стенки кармана Ферми Yo определяется следующим уравнением:

На фиг. 16 глубина канала Ферми представлена как функция концентрации легирующей примеси, используемой для компенсации глубины имплантирования кармана Ферми с целью частичной компенсации условий по напряжению плоских зон, возникающего из разности между реальными потенциалами контактов поликристаллического затвора и подложки. На фиг.17 представлен график глубины кармана Ферми для тех же условий. На фиг.18 представлен график порогового напряжения для тех же критериев. Во всех случаях концентрация легирующей примеси в подложке равна 1Е16 на см3 и α = 1.
Наиболее предпочтительная процедура расчета состоит в том, что прежде всего выбирают желаемое пороговое напряжение. Именно этот выбор определяет компенсацию легирующей примеси, причем величина абсциссы соответствует выбранному пороговому напряжению. К примеру, при пороговом напряжении 0,75 В требуется компенсационное значение 1Е18 для легирующей примеси, которое следует применить для получения глубины канала Ферми в 3300 ангстрем. Глубина Ферми для этого порогового напряжения равна 1245 ангстрем.
На фиг.19 представлен график дельты напряжений плоских зон, которая будет преобладать при данном значении абсциссы. На фиг.16-19 реальный уровень легирующей примеси, используемой при изготовлении микросхем, равняется 6Е19.
Диффузионная барьерная емкость
Чтобы достичь высокой скорости переключения, необходимо уменьшить оба компонента диффузионной барьерной емкости в сравнении с соответствующими значениями у МОП-транзисторов. Речь идет о компоненте, связанном с площадью, и боковом компоненте. На фиг.20 изображены области обеднения, окружающие участки диффузии, предусматриваемые технологией получения кармана Ферми.
Уменьшение компонента емкости, связанного с площадью, имеет место у дна области диффузии и для всех практических целей описывается следующим выражением:

Боковой компонент описывается выражением

где
Xtub - глубина имплантированного кармана Ферми;
Xd - глубина области диффузии;
Z - ширина области диффузии;
Ld - длина области диффузии.
Полная глубина барьера Yo + Yp достаточно велика для уменьшения или устранения необходимости в использовании методов ограничения канала, приводящих к большой емкости. Ограничение канала обычно используется в МОП-транзисторах, чтобы поверхностная инверсия и ток утечки не вышли за границы области диффузии, когда защитный оксидный участок уходит по глубине за край области диффузии. Глубина обеднения в быстродействующем транзисторе Ферми достаточно велика, чтобы защитный оксидный слой в достаточной мере доходил до предельного значения у границы глубины области обеднение Yо+Yp. Поверхностная инверсия происходит в случае, когда

Поверхностная инверсия происходит тогда, когда напряжение на 11 вольт превышает потенциал земли при 30oC.
Fox(Fox) = 8000 ангстрем
ei = 3,45E-13 Ф/см
Na = 1E16 см-3
Ni = 1,5E10 см-3
Эффект кристаллического тела
Понимание порогового напряжения и его зависимости от напряжения на подложке или истоке имеет исключительную важность для правильного моделирования работы схем вообще и высокочастотных особенно. Однако, судя по всему, в технике еще существует некоторая путаница с определением и пониманием порогового напряжения, называемого гамма (γ), а также того, как этот член связан с эффектом кристаллического тела. Например, есть мнение, что гамма прямо пропорционален эффекту кристаллического тела. Обычно это значение отличается от того, которое требуется в уравнении истока, чтобы соответствовать результатам замера. Есть и иные трудности с определениями γ. Эффект кристаллического тела в отношении напряжения на истоке нельзя рассматривать как эффект напряжения подложки. Подобное различие можно наблюдать экспериментально. К примеру, на фиг. 21а и 21в показано появление тока стока с напряжением на затворе у МОП-транзистора для различных напряжений на подложке (0-> 5 B) на фиг. 21а либо для напряжения на истоке фиг. 21в. Из чертежей видно, что эффект кристаллического тела относительно напряжения на подложке dVt/dVsub менее выражен, чем эффект кристаллического тела и напряжения на стоке d(Vt-Vs)/dVs.
Наблюдаемая разность описывается коэффициентом 1,5. Аналогичное явление существует в быстродействующих транзисторах Ферми, хотя у них оба эффекта кристаллического тела примерно на 1/5 больше, чем у МОП-транзистора. Графики на фиг. 21а-21г позволяют сравнить эффекты кристаллического тела для напряжения на подложке и напряжения на истоке при канале P-типа для обеих технологий. По конструкции приборы схожи. Малый эффект кристаллического тела является соизмеримым и отличительным фактором транзистора Ферми, причем по мере укорочения канала он становится более выраженным. Наиболее существенным следует считать малый эффект кристаллического тела, вызываемый приложенным напряжением истока.
Анализ эффекта кристаллического тела у МОП-транзистора
Согласно определению эффект кристаллического тела в зависимости от напряжения подложки является частной производной порогового напряжения относительно напряжения на подложке, а не частной производной потенциала оксидного слоя относительно напряжения на подложке. Напряжение подложки оказывает влияние как на поверхностный потенциал, так и на потенциал оксидного слоя. Член γ является всего лишь удобным средством упрощения уравнения эффекта кристаллического тела. Обычно γ выражается так:

где
Tox - толщина оксидного слоя затвора;
Ns - легирование подложки;
es - диэлектрическая проницаемость кремния;
ei - диэлектрическая проницаемость изолятора.
Выведем уравнение эффекта кристаллического тела для МОП-транзисторов. Подобный вывод для быстродействующих транзисторов Ферми намного сложнее, и для целей данного изобретения нет смысла его приводить. Представим лишь его результаты. На фиг. 22 изображено электрическое поле МОП-транзистора для условий, существующих под оксидным слоем затвора.
Пусть Yp - глубина области объединения в подложке под оксидным слоем,

Фактор K, относящийся к члену напряжения подложки, учитывает тот факт, что заряд области объединения поступает из инверсионной области, псевдообласти N-типа, и для устройства с N-каналом заканчивается в области P-подложки. Как видно далее, фактор K не является постоянной величиной.
Поверхностное поле Es = g NsYp/es описывается следующим выражением:

Воспользовавшись теоремой дивергенции для поверхности раздела оксидного слоя, получают выражение для потенциала оксидного слоя:

или через γ
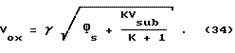
Поверхностный потенциал фs = qNsY
| 2 |
| p |

Следовательно, поверхностный потенциал нельзя считать независимым от напряжения на подложке и поэтому эффект кристаллического тела не описывается как dVox/dVsub.
Выражение порогового напряжения МОП-транзистора

где
Vfb - чистое значение напряжения плоской зоны.
Взяв частную производную от уравнения (36) по напряжению подложки, получают формулу для эффекта кристаллического тела для МОП-транзистора:

Так как эффект кристаллического тела не является отрицательным, из уравнения (37) получают критерий для нулевого напряжения подложки и оценивают параметр K:

На фиг. 23 представлен график порогового напряжения (36) как функции напряжения подложки, и на фиг. 24 представлен график эффекта кристаллического тела от напряжения подложки (37) для случая, когда Ns = 1e17, 2e17 и 3e17 при оксидном слое 150 ангстрем.
В отличие от него эффект кристаллического тела у быстродействующих транзисторов Ферми обычно равен 0,05 B/B или меньше.
Выражение для эффекта кристаллического тела у быстродействующего транзистора Ферми приведено ниже.
Пороговое напряжение равно
Vt =Vfb+фs+Vox, (39)
где



где
глубина канала Ферми Yf равняется
Yf = Yo(Θ - 1). (43)
В быстродействующем транзисторе Ферми фактор β > 1 (в решениях согласно патентам США NN 4990974 и 4984043 требуется Θ ≤ 1).
Эффект кристаллического тела в быстродействующем транзисторе Ферми можно получить, взяв частные производные от (41) и (42) по напряжению подложки и затем просуммировав их.
Заключение
В быстродействующем полевом транзисторе Ферми имеется область кармана Ферми определенной глубины, ее тип проводимости противоположен типу проводимости подложки и совпадает с типом проводимости областей диффузии стока и истока. Карман Ферми проходит на определенной глубине от поверхности подложки, а области диффузии стока и истока имплантируются в область кармана Ферми внутри его границ. Предпочтительная глубина кармана Ферми равна сумме глубины канала Ферми Ys и глубины объединения Yо. Область канала Ферми длиной Yf и шириной Z проходит между областями диффузии стока и истока. Проводимость канала Ферми регулируется напряжением, приложенным к электроду затвора. Емкость затвора в первую очередь определяется глубиной канала Ферми и распределением зарядов в канале и сравнительно не зависит от толщины оксидного слоя затвора. Диффузионная емкость обратно пропорциональна разности между суммой глубин кармана Ферми и области объединения Yо в подложке и глубиной областей диффузии Xd. Желательно, чтобы глубина области диффузии была такой же, как и глубина канала Ферми. При более глубоких конфигурациях глубина области диффузии должна быть меньше глубины кармана Ферми Ytub. Концентрацию легирующей примеси в областях кармана Ферми желательно выбирать такой, чтобы глубина канала Ферми превышала троекратную глубину инверсионного слоя в МОП-транзисторе.
Глубина кармана Ферми определяется следующим образом:

где
α = NfTub/Ns;
Ns - концентрация легирующей примеси в подложке;
Np - концентрация компенсации легирующей примеси;
Nftub - концентрация легирующей примеси в кармане Ферми.
Глубина области Ytub кармана Ферми определяется уравнением

где
фs = 2фf + KT/qln(α). (46)
Диффузия в кармане Ферми на расстоянии Yo определяется уравнением

Расстояние между дном канала Ферми и дном кармана Ферми есть Yо и определено выше. Профиль плотности легирующей примеси по глубине для всей области диффузии стока и истока должен затухать от поверхностного уровня и на дне канала Ферми должен быть по меньшей мере на один порядок. В быстродействующих транзисторах Ферми с каналом N-типа требуется легирование поликристаллического затвора P-типа, а в транзисторах Ферми и каналом P-типа требуется легирование затвора N-типа.
В обоих случаях концентрация легирующей примеси должна равняться 5E19 или более. Желательно, чтобы в быстродействующих транзисторах Ферми величина эффекта кристаллического тела от подложки была меньше 0,05 В/В.
На чертежах и в описании были раскрыты предпочтительные варианты реализации изобретения, но, хотя в них использовались конкретные понятия, они имеют обобщенный и описательный смысл и не служат цели ограничения испрашиваемых прав, поскольку объем изобретения определяется представленной формулой изобретения.
Формула изобретения
1. Полевой транзистор, содержащий полупроводниковую подложку первого типа проводимости с первой поверхностью, область кармана второго типа проводимости в подложке у первой поверхности, разнесенные области истока и стока второго типа проводимости в области кармана у первой поверхности, изоляционный слой затвора на подложке на первой поверхности между разнесенными областями истока и стока и контакты истока, стока и затвора для электрического контактирования с областями истока и стока и изоляционным слоем затвора соответственно, отличающийся тем, что полевой транзистор содержит канал второго типа проводимости в области кармана у первой поверхности между разнесенными областями истока и стока, при этом канал проходит на первой определенной глубине от первой поверхности, область кармана проходит на второй определенной глубине от канала, область истока проходит на третьей определенной глубине от первой поверхности, причем третья глубина больше первой глубины и меньше суммы первой и второй глубин.
2. Транзистор по п. 1, отличающийся тем, что исток легируется примесью второго типа проводимости при концентрации легирующей примеси, уменьшающейся от первой поверхности до третьей определенной глубины.
3. Транзистор по п. 2, отличающийся тем, что центр масс легирующей примеси находится на глубине, равной половине первой определенной глубины.
4. Транзистор по п. 1, отличающийся тем, что по меньшей мере одна из определенных первой и второй глубин выбирается так, что составляющая электрического поля, перпендикулярная первой поверхности, на первой определенной глубине равна нулю.
5. Транзистор по п. 4, отличающийся тем, что по меньшей мере одна из определенных первой и второй глубин дополнительно выбирается так, что составляющая электрического поля, перпендикулярная первой поверхности, от первой определенной глубины до первой поверхности при положении порогового напряжения к контакту затвора равна нулю.
6. Транзистор по п. 1, отличающийся тем, что вторая определенная глубина выбирается для создания такого порогового напряжения у полевого транзистора, которое равно удвоенному потенциалу Ферми полупроводниковой подложки.
7. Транзистор по п. 1, отличающийся тем, что по меньшей мере одна из определенных первой и второй глубин выбирается такой, чтобы носители заряда второго типа проводимости могли течь из области истока к области стока по области канала, проходящей от первой определенной глубины к первой поверхности по приложению к контакту затвора напряжения, превышающего пороговое напряжение полевого транзистора.
8. Транзистор по п. 1, отличающийся тем, что по меньшей мере одна из определенных первой и второй глубин выбирается такой, чтобы носители заряда второго типа проводимости могли перемещаться внутри области канала от области истока к области стока и под первой поверхностью без создания инверсионного слоя в канале.
9. Транзистор по п. 1, отличающийся тем, что подложка снабжена электрическим контактом, при этом контакт затвора содержит слой поликристаллического кремния первого типа проводимости и затворный электрод на слое поликристаллического кремния против изоляционного слоя затвора, причем по меньшей мере одна из определенных первой и второй глубин выбирается для создания такого напряжения на первой поверхности, смежной с изоляционным слоем затвора, которое равно и противоположно по знаку сумме напряжений между контактом подложки и подложкой и между слоем поликристаллического кремния и электродом затвора.
10. Транзистор по п. 1, отличающийся тем, что подложка снабжена электрическим контактом, при этом по меньшей мере одна из первой и второй определенных глубин выбирается для изменения порогового напряжения полевого транзистора менее чем на одну двадцатую вольта, когда напряжение, приложенное к контакту подложки, меняется на один вольт.
11. Транзистор по п. 1, отличающийся тем, что подложка легируется с концентрацией легирующей примеси Ns, имеет собственную концентрацию носителей заряда Ni при температуре T градусов Кельвина и диэлектрическую проницаемость es, полевой транзистор содержит электрический контакт подложки и канал в нем проходит на первой определенной глубине Yf от первой поверхности, и область кармана проходит на второй определенной глубине Yo от канала, при этом область канала легируется с такой концентрацией легирующей примеси, которая в α раз отличается от Ns, и затворный контакт содержит слой поликристаллического кремния первого типа проводимости, легированный с концентрацией легирующей примеси Np и первая определенная глубина Yf равна

где q равняется 1,6•10-19 Кулон, а K равен 1,38•10-23 Дж/K.
12. Транзистор по п. 11, отличающийся тем, что вторая определенная глубина Yo равна

где Фs равняется 2Фf+ KT/qLnα, а Фf - потенциал Ферми полупроводниковой подложки.
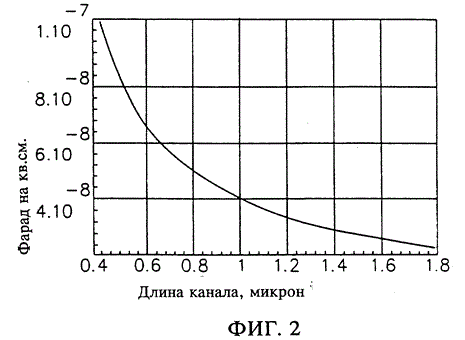
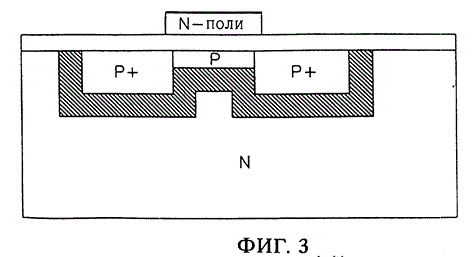
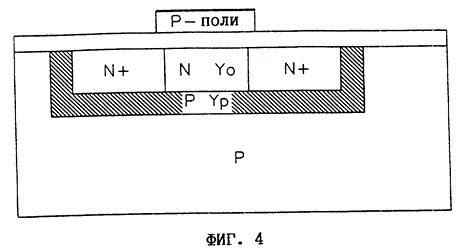
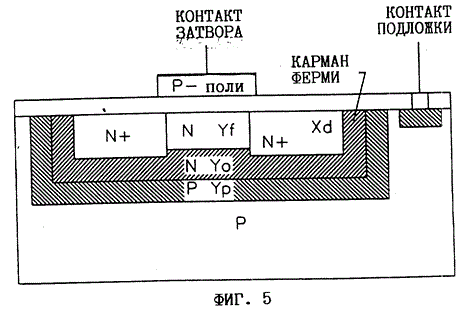
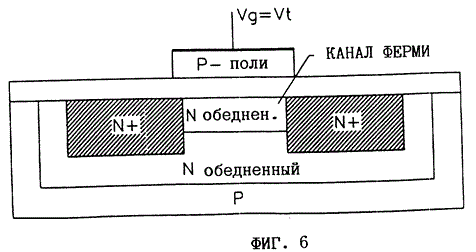
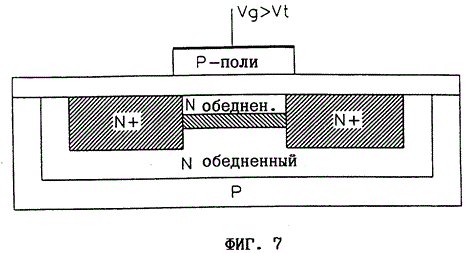
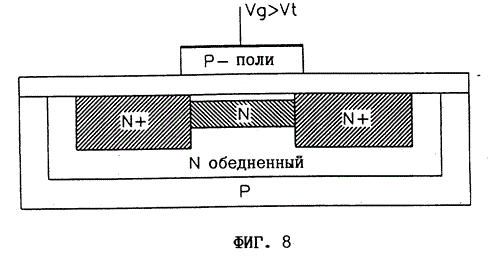
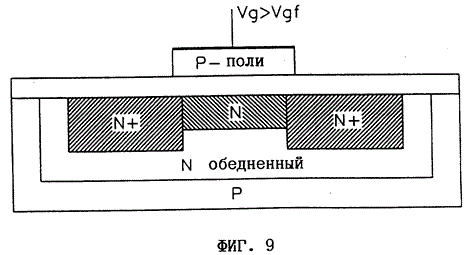
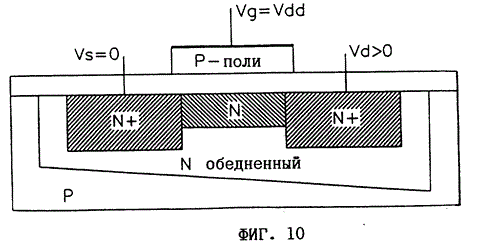
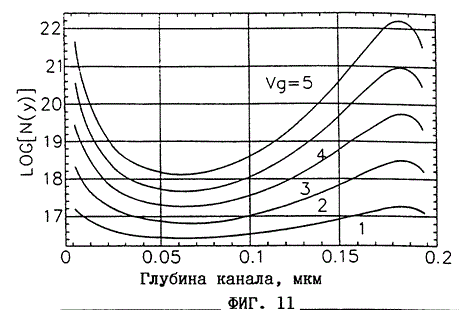
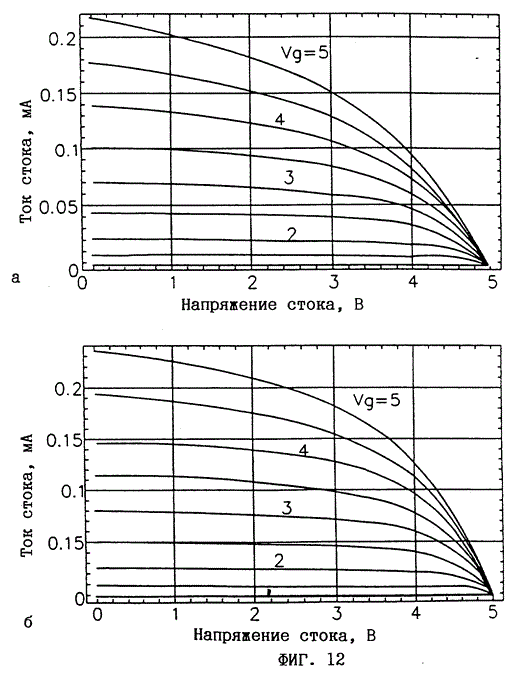
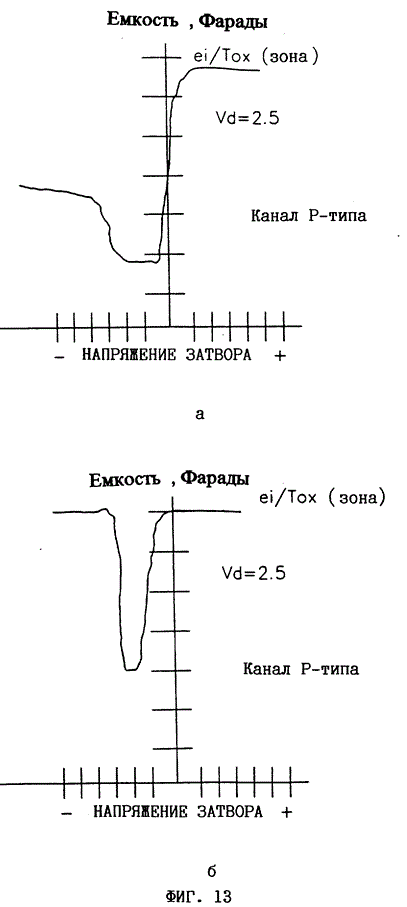
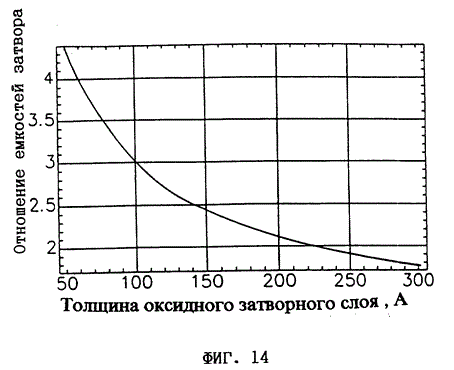
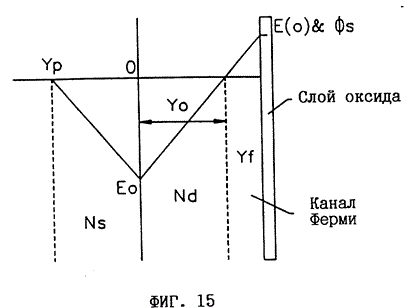

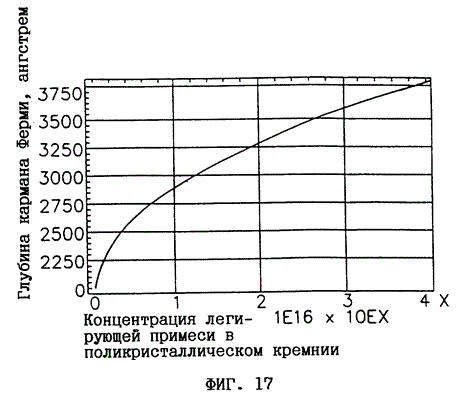
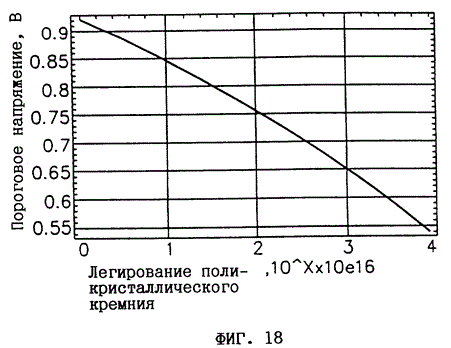

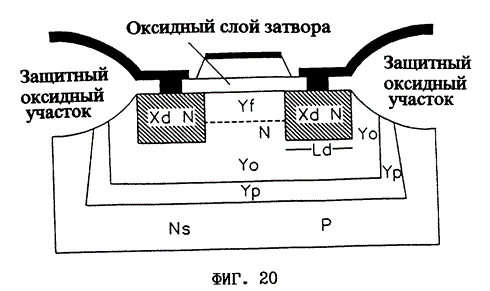
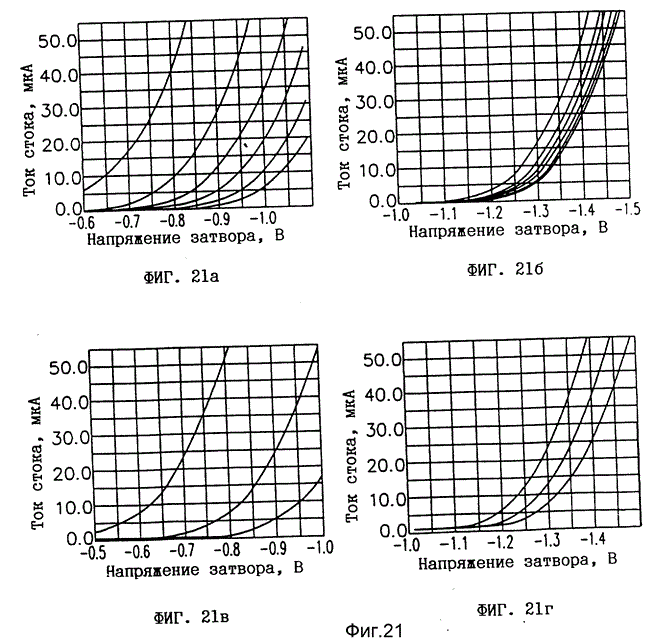
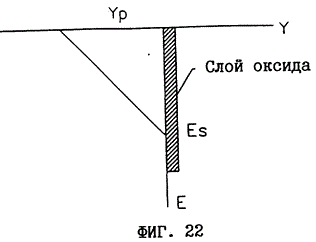
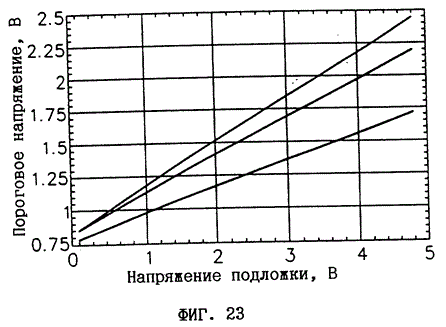

ИЗВЕЩЕНИЯ
MM4A - Досрочное прекращение действия патента СССР или патента Российской Федерации на изобретение из-за неуплаты в установленный срок пошлины за поддержание патента в силе
(21) Регистрационный номер заявки: 0094036010
Дата прекращения действия патента: 29.01.2010
Извещение опубликовано: 27.11.2010БИ: 33/2010